《炬丰科技-半导体工艺》半导体晶圆清洗站多化学品供应系统的讨论
书籍:《炬丰科技-半导体工艺》
文章:半导体晶圆清洗站多化学品供应系统的讨论
编号:JFKJ-21-1075
作者:炬丰科技
引言
半导体制造工业中的湿法清洗/蚀刻工艺用于通过使用高纯化学品清洗或蚀刻来去除晶片上的颗粒或缺陷。扩散、光和化学气相沉积(CVD)、剥离、蚀刻、聚合物处理、清洁和旋转擦洗之前有预清洁作为湿法清洁/蚀刻工艺。清洗工艺在半导体晶片工艺的主要技术之前或之后进行。晶片上的颗粒和缺陷是在超大规模集成电路制造过程中产生的。控制硅片上的颗粒和缺陷是提高封装成品率的主要目标。随着更小的电路图案间距和更高的大规模集成电路密度,已经研究了颗粒和微污染对晶片的影响,以提高封装产量。湿法清洗/蚀刻工艺的湿法站配置有晶片装载器/卸载器、化学槽、溢流冲洗槽和干燥器。
介绍
本文开发了多化学品供应系统,并将其应用于湿式站,该系统采用多化学品同浴工艺。多化学品供应系统有两个化学品瓶、气动系统、两个供应泵、电容传感器、化学分析仪和可编程逻辑控制器(PLC)单元。为了控制两种化学品的浓度,供给泵控制逻辑使用可编程逻辑控制器编程。
实验
图1显示了在三京湿法站中使用的一种槽配置,其中100:1稀释氢氟酸(DHF)化学品和去离子水(去离子水)被供应到槽中。DHF化学用于预扩散清洗、预氧化物剥离和氧化物蚀刻。浴槽由聚四氟乙烯材料制成,过滤器用于过滤化学品颗粒。浴槽温度由在线加热器控制。在这种槽结构中,只有一种化学物质用于清洗过程。
图2显示出了修改成具有多化学品供应系统的浴槽构造,其用虚线框描述。多化学品供应系统可以分别供应两种化学品。
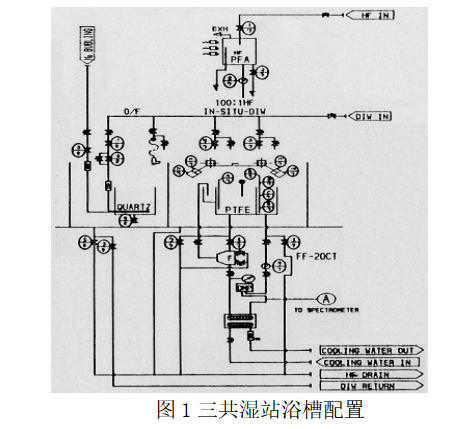
在图4中,化学物质的供应是用隔膜泵和刺针泵进行的,用于快速(通过隔膜泵)和精确(通过刺针泵)泵送。供应的化学品量由配置在化学槽外部的极限传感器测量。化学浴中的化学浓度由化学分析仪测量和反馈。在这个化学供应系统中,两个化学瓶被用作化学源。
结果和讨论
多化学品供应系统的性能在湿法站中使用SC-1化学品通过石英浴进行评估,该化学品包括:NH4OH + H2O2 + DIW = 1:4:20(体积比)NH4OH + H2O2 + DIW = 1:5:113(重量比)
在25℃±5℃时,(1)其中,NH4OH为29%溶液,H2O2为30%溶液,DIW为去离子水。
图6显示了作为化学品供应时间的函数的SC-1化学品的浓度瞬态趋势。从图6中,NH4OH和H2O2在10分钟内沉降,浓度偏差分别为1.33重量%和0.23重量%。在使用SC-1化学品的镀液中,化学品的供应按DIW、NH4OH和H2O2的顺序进行。浓度偏差取决于化学分析仪的分辨率和峰值泵流量。测量数据足以满足镀液浓度控制值的要求规格,建议小于10分钟,浓度偏差为5wt%。
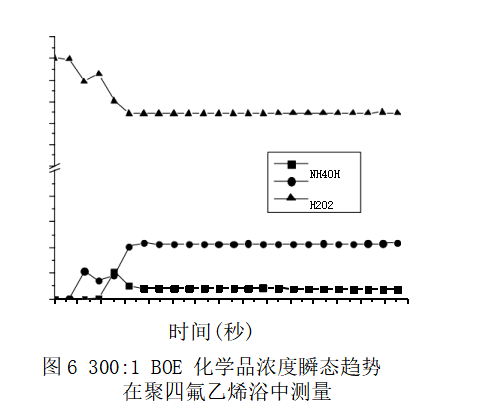
总结
所开发的多化学品供应系统被应用于使用多种化学品(如SC-1)的单浴清洁工艺的湿式站。在浴槽中测量每种化学品的浓度,以验证多化学品供应系统。浓度控制范围在NH4OH中测量为1.33重量%,在H2O2中测量为0.23重量%。开发的多化学品供应系统可移动,可作为固定湿式站的独立模块使用。通过简单地修改可编程控制器,所提出的多化学品供应系统可以很容易地扩展到包含许多化学品。
